삼성, 업계 최대 용량 36GB HBM3E 12H 개발
글로벌 HBM 시장 선두 SK하이닉스에 도전장
SK, 5세대 HBM 양산 초읽기…1위 굳히기 나서

AI(인공지능) 반도체 대전이 한창인 가운데, 삼성전자와 SK하이닉스 간 글로벌 HBM(고대역폭메모리) 기술경쟁이 뜨겁게 전개되고 있다. 삼성전자는 업계 최초로 D램 칩을 12단으로 쌓은 5세대 HBM 개발에 성공했고, SK하이닉스는 차세대 HBM인 ‘HBM3E’ 양산 초읽기에 돌입했다.
삼성전자는 24Gb D램 칩을 실리콘 관통 전극(TSV) 기술로 12단까지 적층해 업계 최대 용량인 36GB HBM3E 12H를 구현했다고 27일 밝혔다.
TSV는 수천개의 미세 구멍을 뚫은 D램 칩을 수직으로 쌓아 적층된 칩 사이를 전극으로 연결하는 기술이다. 삼성은 이 기술을 기반으로 3GB 용량인 24Gb D램 12개를 수직으로 쌓아 현존 최대 용량을 구현하는 데 성공했다.
이번에 개발한 HBM3E 12H는 성능과 용량 모두 전작인 ‘HBM3’ 8H 대비 50% 이상 개선됐다. 특히 초당 최대 1280GB를 처리할 수 있다. 이는 1초에 30GB 용량의 UHD 영화 40여 편을 업로드 또는 다운로드할 수 있는 속도다.
칩 두께를 최소화하는 데에도 힘썼다. 삼성은 ‘첨단 열압착 비전도성 접착 필름(TC NCF)’ 기술로 12단 적층 제품을 8단 적층 제품과 동일한 높이로 구현했다. 첨단 TC NCF 기술을 적용하면 HBM 적층 수를 늘리면서도, 얇은 칩 두께로 인해 발생할 수 있는 휘어짐 현상을 크게 줄여준다.
뿐만 아니라 NCF 소재 두께도 낮춰 업계 최소 칩 간 간격인 7마이크로미터(1㎛는 100만분의 1m)를 구현했다. 이를 통해 전작인 HBM3 8H 대비 20% 이상 향상된 수직 집적도를 실현했다.
특히 칩과 칩 사이를 접합하는 공정에서 신호 특성이 필요한 곳은 작은 범프(칩 사이를 전기적으로 연결하기 위해 형성한 전도성 돌기)를, 열 방출 특성이 필요한 곳에는 큰 범프를 적용해 열 특성을 강화하는 동시에 수율도 극대화 했다.
삼성전자 관계자는 “NCF로 코팅하고 칩을 접합해 범프 사이즈를 다양하게 함과 동시에 공극(Void) 없이 적층하는 기술력을 선보였다”고 설명했다.

삼성전자가 개발한 36GB HBM3E 12H. <사진=삼성전자>
삼성의 HBM3E 12H는 AI 서비스 고도화로 데이터 처리량이 급증하는 최근 추세 속에서 최고의 솔루션이 될 것으로 기대를 모으고 있다. 해당 제품을 활용할 경우 GPU(그래픽처리장치) 사용량이 줄어 총 소유 비용(TCO)을 절감할 수 있다는 게 삼성전자의 설명이다.
일례로 서버 시스템에 HBM3E 12H를 적용하면 HBM3 8H를 탑재할 때보다 AI 학습 훈련 속도를 평균 34% 개선할 수 있는 것으로 나타났다. 추론의 경우에는 최대 11.5배 많은 AI 사용자 서비스가 가능하다.
삼성전자는 이번에 개발한 HBM3E 12H의 샘플을 고객사에 제공하기 시작했다. 해당 제품은 올 상반기 중 양산될 예정이다.
배용철 삼성전자 메모리사업부 상품기획실장 부사장은 “삼성전자는 AI 서비스를 제공하는 고객사의 고용량 솔루션 니즈에 부합하는 혁신 제품 개발에 힘쓰고 있다”며 “앞으로 HBM 고단 적층을 위한 기술 개발에 주력하는 등 고용량 HBM 시장을 선도하고 개척해 나가겠다”고 밝혔다.
이날 삼성이 업계 최대 용량을 자랑하는 차세대 HBM을 공개하면서, SK하이닉스와의 정면 대결이 불가피하게 됐다. 삼성전자는 그동안 글로벌 HBM 시장에서 SK하이닉스에 한발 밀린다는 평가를 받아 왔다.
시장조사업체 트렌드포스에 따르면 2022년 기준 SK하이닉스의 글로벌 HBM 시장 점유율은 50%에 달한다. 삼성전자는 40%로, SK의 뒤를 맹추격하고 있다. 양사 간 점유율 격차는 10%p로, 간극이 크지는 않다.
그러나 SK하이닉스가 AI 반도체 시장을 선도하고 있는 엔비디아에 사실상 독점적으로 HBM 제품을 공급하고 있다는 점을 고려할 때 삼성이 점유율 차이를 줄여 나가기란 쉽지 않은 상황이다.

삼성전자가 D램 칩을 12단까지 적층해 최대 용량을 지원하는 36GB HBM3E 12H 기술을 구현하고, 올 상반기까지 양산에 들어간다. 사진은 이재용 삼성전자 회장(오른쪽에서 두번째)이 천안캠퍼스에서 반도체 제품을 살펴보고 있는 모습. <사진제공=삼성전자>
삼성은 글로벌 HBM 시장 내 경쟁력을 제고하기 위한 해법으로 기술 초격차 전략을 내세우고 있다. 고성능·고용량의 차세대 HBM을 개발해 시장 주도권을 쟁취하고, 메모리 업계에서의 위상을 높여 나간다는 구상이다.
경계현 삼성전자 DS(디바이스솔루션) 부문장 사장도 전 세계 HBM 시장 선점에 대한 자신감을 드러냈다. 경 사장은 지난 15일 SNS에서 “삼성의 기술력이 총망라된 HBM3E ‘샤인볼트’ 등 반도체 제품은 생성형 AI 애플리케이션의 속도와 효율성을 크게 향상시킬 준비가 돼 있다”고 강조했다.
HBM3E에서 한 단계 더 진보한 6세대 HBM ‘HBM4’도 2025년 샘플링과 2026년 양산을 목표로 개발 중이다. 삼성전자는 HBM4 16H 초고용량 제품에서 칩과 칩 사이 갭을 완전히 없애고, 칩을 완전히 붙이는 신공정도 개발중에 있다.
삼성전자 관계자는 “HBM3E, HBM4 등 차세대 HBM으로의 전환에 속도를 높여 날로 높아지는 AI 반도체 시장의 요구에 적극 대응할 계획이다”며 “글로벌 HBM 시장 선도 업체로서 제품 경쟁력과 안정적인 공급력 등을 기반으로 시장 리더십을 강화하겠다”고 강조했다.
삼성전자의 추격전이 본격화 하고 있는 가운데, SK하이닉스는 차세대 HBM 칩 양산으로 선두자리를 굳힌다는 전략이다.
SK하이닉스는 최근 HBM3E의 첫 번째 ‘로트(Lot)’를 찍은 것으로 파악됐다. 로트는 반도체 제조 공정 중 제품이 이동하는 단위를 뜻한다. 통상적으로 25개의 웨이퍼가 하나의 로트로 이뤄진다. 웨이퍼는 반도체 공정에 투입되는 순서에 따라 고유의 로트 번호를 갖고, 이를 통해 각 공정별 진행 상태와 특이사항 등을 확인할 수 있다.
첫 번째 로트를 찍었다는 것은 반도체 양산이 임박했다는 뜻으로 해석된다. 그간 SK하이닉스는 올 상반기 중에 HBM3E를 생산할 예정이라고 밝혀 왔다. SK하이닉스 관계자는 지난달 25일 열린 지난해 4분기 실적 콘퍼런스콜에서 “HBM3E 제품의 경우 양산 준비가 순조롭게 진행되고 있으며, 올 상반기 중 공급 예정이다”고 밝힌 바 있다.

SK하이닉스 HBM3E. <사진=오창영 기자>
곽노정 SK하이닉스 대표이사 사장도 차세대 HBM 양산이 머지않았음을 시사했다. 곽 사장은 이날 서울 중구 대한상공회의소(대한상의)에서 열린 ‘민·관 반도체 전략 간담회’에서 취재진들과 만나 “HBM3E은 저희가 예상하고, 계획한 일정대로 양산 준비 중이다”고 강조했다.
‘3월 양산설’에 대해서는 “꼭 특정해서 말씀드려야 하냐”며 “올 상반기 중으로 봐 달라”고 답했다.
곽 사장이 HBM3E 생산 시점에 대해 공식적으로 언급한 것은 이번이 처음이다. 업계에서는 곽 사장이 3월 양산설에 대해 부정하지 않은 만큼 이르면 다음달부터 HBM3E가 본격 제조될 것으로 점치고 있다.
SK하이닉스는 6개월에 걸친 엔비디아의 성능 평가를 마치고, 지난달 HBM3E 개발을 공식적으로 마친 상태다. 현재는 램프업(생산량 증대)에 들어갔고, 납품 준비까지 마무리한 것으로 보인다. 이에 SK가 다음달 중 엔비디아로부터 최종 제품 품질 인증 획득하고, HBM3E 양산과 납품에 본격적으로 돌입할 것이라는 게 업계의 중론이다.
차세대 제품 개발에도 적극 매진하고 있다. SK는 6세대 HBM인 ‘HBM4’가 2026년께부터 시장 지배적 제품이 될 것으로 판단하고, 이에 맞춰 개발·양산을 준비하고 있다.
SK하이닉스 관계자는 “향후 5년 간 AI 반도체 시장은 40%가량 성장할 것으로 전망된다”며 “HBM 수요는 연평균 80% 증가할 것으로 보인다”고 말했다. 그러면서 “이같은 장밋빛 전망에 힘입어 SK하이닉스는 글로벌 HBM 시장을 지속적으로 선도해 나갈 것이다”고 덧붙였다.
[CEO스코어데일리 / 오창영 기자 / dongl@ceoscore.co.kr]





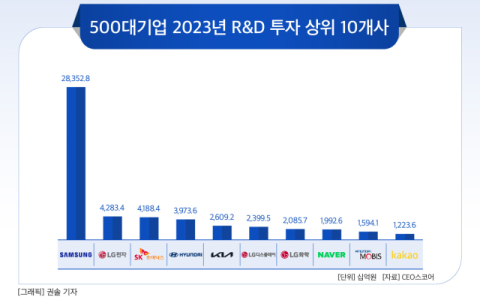
![[중견차 3사3색 돌파구] ③KG모빌리티, 전방위 체질개선 돌입…신시장 개척 박차](https://www.ceoscoredaily.com/photos/2024/05/02/2024050216511838910_m.jpg)
![[중견차 3사3색 돌파구] ②르노코리아, ‘르노 DNA’로 새출발…신차 공세 ‘시동’](https://www.ceoscoredaily.com/photos/2024/04/30/2024043016323768783_m.jpg)
![[중견차 3사3색 돌파구] ①한국GM, 쉐보레·캐딜락·GMC ‘멀티 브랜드 전략’ 가속](https://www.ceoscoredaily.com/photos/2024/04/29/2024042917410481170_m.jpg)

![[그래픽] KG모빌리티 연간 실적 추이](https://www.ceoscoredaily.com/photos/2024/05/03/2024050309374477535_m.jpg)
























































































![[24-03호]_500대기업 R&D 투자 현황](https://www.ceoscoredaily.com/photos/2024/04/17/2024041718513086340_m.jpg)

![[이달의 주식부호] 홍라희 여사 2위 탈환…곽동신 한미반도체 부회장 6위로 2계단↑](https://www.ceoscoredaily.com/photos/2024/04/03/2024040314314813956_m.jpg)



![[그래픽] 그레이트 컴퍼니 우수기업 리스트](https://www.ceoscoredaily.com/photos/2023/08/24/2023082410452781615_m.jpg)



댓글
[ 300자 이내 / 현재: 0자 ]
현재 총 0개의 댓글이 있습니다.